編採中心/台北報導
以「功率元件及模組」創新的封裝技術切入第三代半導體的智威科技(Zowie Technology),和日本 SiC 元件製造商合作開發,於日前董事長鍾宇鵬在線上發表會「第三代半導體的決勝關鍵」上,發表「650V-1200V SiC SBD diode 10-40A 」產品,是目前全球功率最高、最小型化的 SiC 元件,受到日本時事社、朝日新聞、日本產經新聞等日本媒體關注及報導,可說是科技界的台灣之光!

▲傳統封裝與智威封裝的外觀比較,可以看出智威封裝外型輕薄短小,而且是適用於在電路板上表面黏著方式組裝(SMD),對於越來越密集電路需求,如汽車電裝應用,至關重要!(圖/智威科技提供)
鍾宇鵬表示,化合物半導體(Compound Semiconductor,或稱第三代半導體)已經成為未來半導體發展的焦點,預計未來5年的年複合成長率可高達35%以上。然而當大家對晶圓及元件大舉投入的時候,很遺憾的在「封裝」上,卻沒有比較新的技術發展,對於其中像SiC (silicon carbide)是以較大功率應用為主的元件,不論就應用及產業的發展上,都形成了困難及障礙。
在技術突破上,鍾宇鵬說,智威科技運用材料和製程技術的創新,以系統性的思維,發展出功率半導體的新的封裝技術平台。它可優化每一層從晶片到系統的接點(Joints),以及全新的材料應用,將 SiC 晶片的優勢發揮到極致。這項技術對功率元件封裝及模組(Power Component and Module Packaging)是極具創新性的改變,同時也是產業典範移轉的重要里程碑 。
台灣要進入到第三代半導體,其決勝關鍵在於「先進功率封裝技術」,鍾宇鵬如此表示,智威科技日後將會以此先進封裝技術為基礎,並成為未來半導體發展的重要技術指標,持續發展新規格及產品,甚至可以主導半導體的發展。智威科技在這方面有多年的創新經驗,將逐步在功率封裝,尤其 SiC 元件及模組封裝上,持續對產業做出相當貢獻。目前該SiC系列產品,只在日本及台灣發行,主要市場為車用、充電樁、高階音響以及大功率電源。面對日益成長的市場,智威科技已預備每月五百萬顆產能,預計2022年規模化量產。
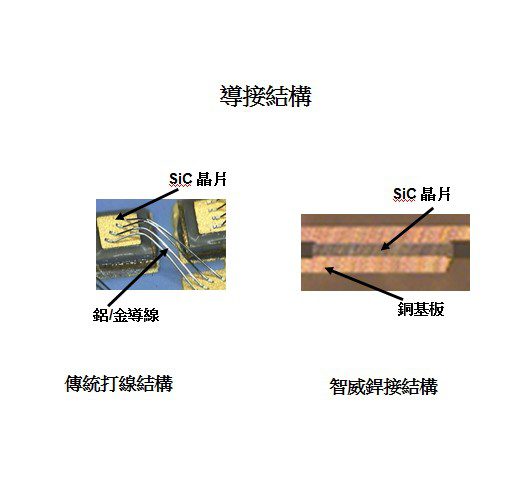
▲封裝內部結構比較圖,傳統封裝以細金或鋁線導接,成為電流流通的瓶頸,不但效能大打折扣,可靠度風險更高.經常又以多條導線來弭補導通不足,將使可靠度問題又更難掌握。智威以相當厚的銅基板導接,使得熱及電的導通問題獲得解決,同時在長期使用的穩定度及環境溫濕度變化的可靠度上,大幅度獲得提升。(圖/智威科技提供)
在這次發佈會上,智威科技董事長鍾宇鵬談到主要的封裝技術特色如下:
1.晶片導接為大面積銲接(soldering)方式,而非傳統打線(wire bonding)導接,如此可使導電率及熱傳導大幅提升。實測對於 SiC 效能的提升,可達 50-100%。其實以銲接取代打線,一直是業界盼望的方式,然因為技術及材料諸多的障礙,直到近期才有 SiC 元件以焊接方式導接的產品出現。
2.使用全面積的高散熱銅基板,而且是直接晶片導接銅基板(DCB),是最佳的散熱模式。對於功率元件而言,整個系統所重視的是效率及可靠度,而其中散熱能力是關鍵,智威封裝散熱基板面積比(高散熱基板面積/封裝面積)可以高達150-180%,相較傳統約40-120% 大幅提升,因此顯著的提升散熱效果。
3.能大幅降低 SiC 元件總成本,加速 SiC 應用普及化。目前除在汽車或工業等用途,SiC 市場成長的主要障礙,還是在成本明顯高於矽基產品。而藉由封裝效能提升,成本可以有30-50% 的降幅,將可望推動新的應用市場。
4. 可以輕易做多晶片封裝、系統或子系統封裝(SIP,system in package).同時由於極高的散熱及傳導方式,整體尺寸可大幅縮小,甚至只有傳統封裝的 10-30% 的體積,這對於車用電子及通訊產品,都有很大的幫助。




